135 1077 0268(24小时热线)
一、背景介绍
BGA的全称是Ball Grid Array(焊球阵列封装),它是一种高密度表面装配封装技术。在这种封装方式中,封装体基板的底部制作有阵列锡球,这些锡球作为电路的I/O端与印刷线路板(PCB)互接。BGA技术是半导体行业封装的重要形式之一,用于封装各种集成电路芯片,如CPU、GPU、FPGA、ASIC等。这些芯片在电子设备中扮演着核心角色,因此BGA封装技术的性能和质量对整个电子产品的性能和可靠性至关重要。而其中,BGA锡球尺寸的测量是半导体封装工艺中的一个重要环节,其准确性直接影响到封装的性能和可靠性,BGA锡球尺寸的测量主要包括锡球的高度、平面度、位置度等关键指标,这些指标对于确保锡球顶端及间距的精确性至关重要,从而保证封装后的芯片能够稳定、高效地工作。
二、配置方案
思瑞OPTIV ADVANCE系列高精度通用型影像测量仪,结构稳定,搭载设计可靠的 3D 复合式测量系统,机身采用高稳定性固定桥式结构,整机采用花岗岩框架,稳定性好,三轴均为中央驱动,采用直线导轨,保证了传动的精密性。同时搭配LMI 2512 线激光实现平面度测量。

三、检测流程
1.在影像模式下,用外框边定位建坐标系。
2.工件球体排列均匀,采用21*2阵列测量球体并求出其位置度。
3.切换至线激光模式,分两次进行点云扫描。
4.软件进行影像定位球中心,点云指定点提取Z方向最高点求其平面度。
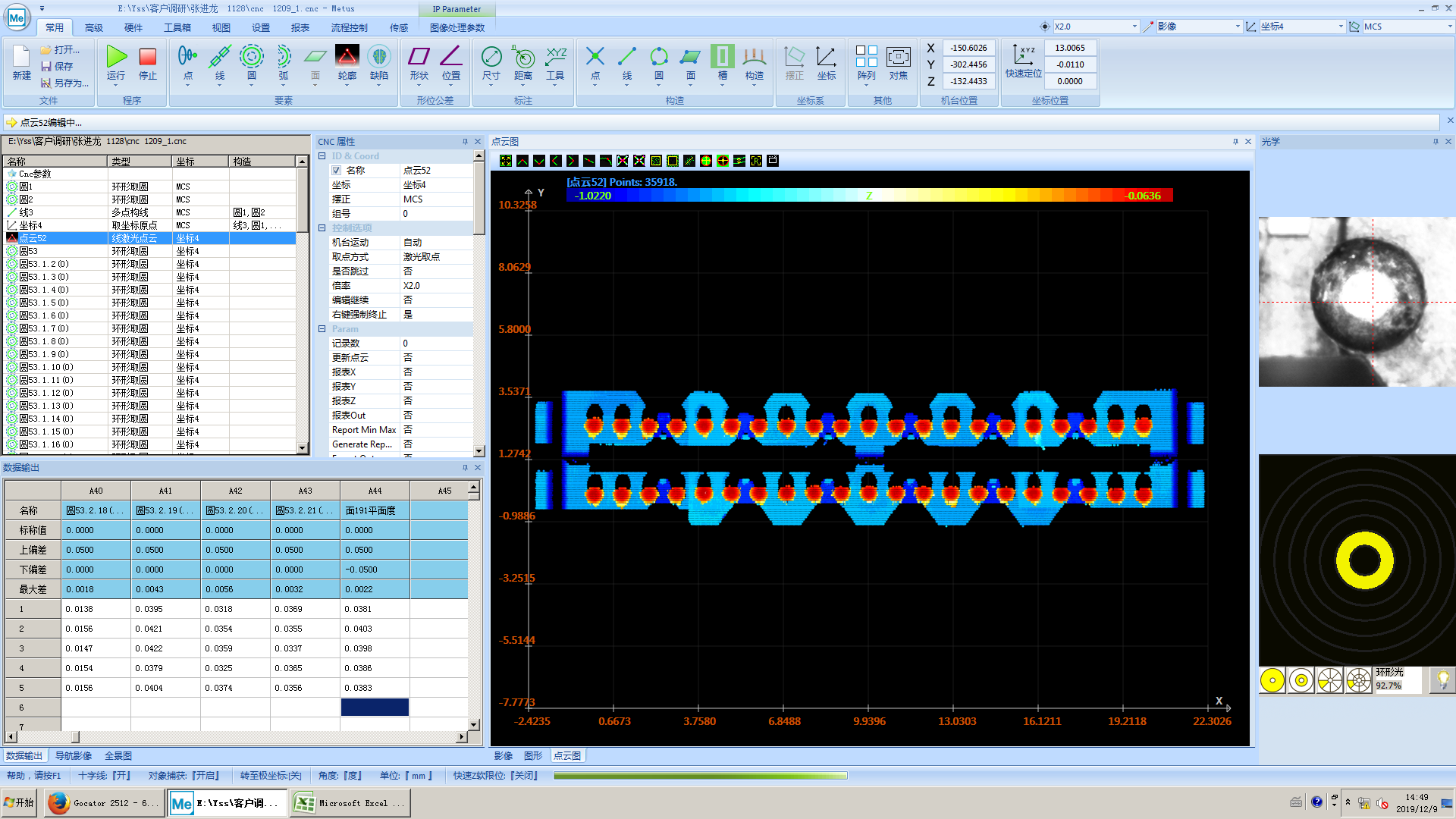
四、检测思路
1.在进行BGA位置度测量之前,需要确保BGA芯片处于良好的状态,没有受到污染或损坏。
2.由于BGA焊点的尺寸较小且分布密集,阵列的偏移值需精准计算。
3.用LMI激光扫描点云,得出每个球体的最高点求出平面度,扫描易有杂点,数值会有突跳,编程时需注意取点方式。
在新能源BGA检测中,思瑞OPTIV ADVANCE影像仪可高效测量锡球位置度、高度和平面度。设备结构稳定,重复性好,软件操作贴合实际需求,有效应对密集焊球的检测挑战。对于高可靠性封装质量控制,思瑞提供了稳定、实用的测量解决方案。